CoPoS 全稱為「Chip-on-Panel-on-Substrate」,是台積電繼 CoWoS 之後的次世代先進封裝平台 。
在 AI 晶片供不應求、全球瘋搶 CoWoS 產能的當下,台積電(TSMC)董事長魏哲家已在法說會證實,正全力研發下一代技術:CoPoS 。這項被下達封口令的「最高機密」,被視為延續護國神山獨霸地位的關鍵 。
本文將為您解密 CoPoS 是什麼?和 CoWoS差異?CoPoS 概念股有哪些?它為何能達成產能翻倍、材料零浪費的驚人效益。
目錄
CoPoS是什麼?30秒快速看懂台積電新封裝技術
CoPoS 的全稱為「Chip-on-Panel-on-Substrate」,這項晶圓代工大廠台積電的先進封裝技術,是繼CoWoS之後的次世代平台,兩者皆屬於先進封裝,任務是將負責大腦運算的邏輯晶片,與負責資料存取的高頻寬記憶體(HBM)精密地「打包」在一起,讓兩者近距離溝通,發揮AI晶片的極致效能。
CoPoS屬扇出型面板級封裝(Fan-Out Panel-Level Packaging,FOPLP)的一種,是將封裝的中介層,從傳統的圓形晶圓片,改為方形的玻璃或有機面板。
CoPoS vs CoWoS差在哪?差異比較與技術一次看懂
CoPoS 和 CoWoS 的主要差異,關鍵在於中介層(Interposer)的材料與形狀革命 。
CoPoS 與 CoWoS 差異
| 項目 | CoWoS (Chip-on-Wafer-on-Substrate) | CoPoS (Chip-on-Panel-on-Substrate) |
|---|---|---|
| 中介層 | 中介層為12吋矽晶圓片,直徑為300公厘。 | 中介層改為方形,材質為有機板材或玻璃等。 |
| 面積利用率 | 約 65% (受限邊角浪費) | 約 95% (極致利用) |
| 晶片產量 | 較低。推算輝達B系列只能放4組。 | 可翻倍。預計為310公厘見方,輝達B系列可放9至16個。 |
| 技術地位 | 成熟量產中 | 新一代研發 / 試產中 |
CoPoS vs CoWoS:圖解台積電先進封裝新技術
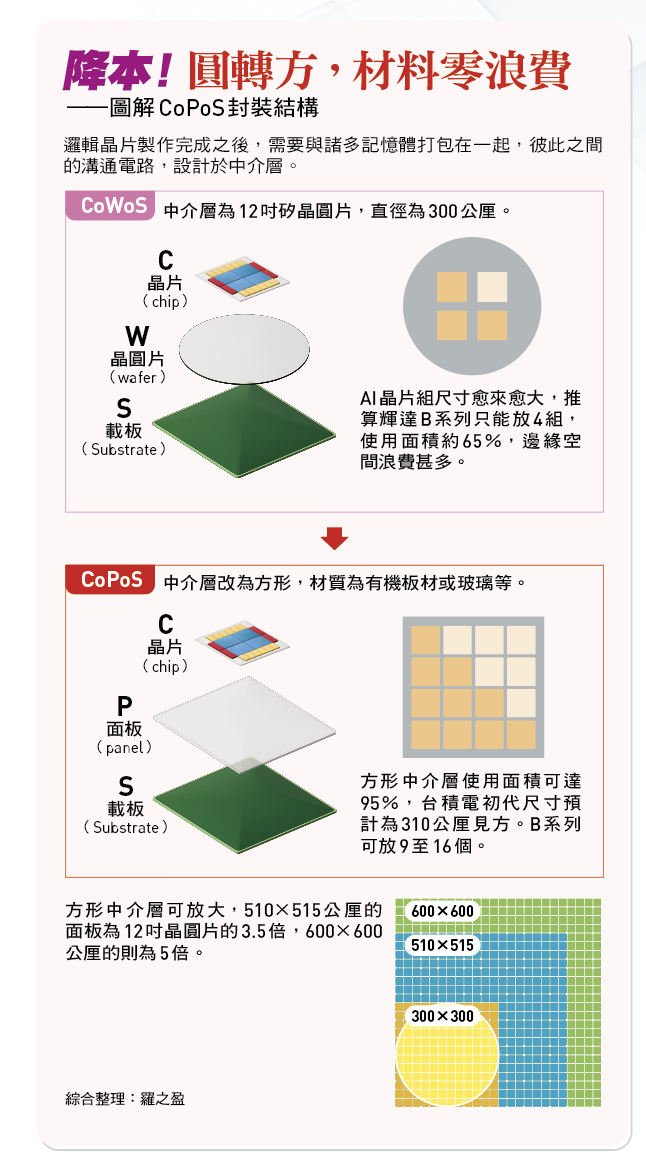
CoPoS 為什麼能讓產能翻倍?3大關鍵原因解析
CoPoS 產能提升的核心在於「形狀」的物理優勢。
1. 「以方代圓」減少浪費
傳統 12 吋圓形晶圓在封裝大型 AI 晶片時,邊角空間因無法放置方形晶片而產生大量浪費 。
2. 晶片產出量大增
以 NVIDIA B200 晶片為例,12 吋圓形晶圓僅能封裝 4 組,但若改在同尺寸的方形面板上,保守估計可封裝 9 至 16 組 。這等同於讓封測產能在同樣的材料面積下「隱形增建」了一倍以上 。
3. 符合 ESG 目標
高達 95% 的利用率大幅減少材料廢料,達成節能減碳的生產效益 。
CoPoS能解決什麼問題?AI晶片產能瓶頸的關鍵解方
CoPoS主要為了應對以下挑戰:
1. 供不應求的 AI 核心:儘管 CoWoS 產能預計到 2026 年底達到每月 10 萬片,但訂單滿足率仍僅約 80%,輝達(Nvidia)等大廠仍在大排長龍 。
2. 晶片體積愈來愈大:隨著 AI 運算需求提升,單顆晶片封裝尺寸已突破光罩極限 。CoPoS 封裝不受限於圓形晶圓尺寸,能提供更大的空間容納更多裸晶(die)與 HBM 。
CoPoS最大技術挑戰是什麼?「圓改方」3大難關解析
CoPoS雖然效益迷人,但「圓改方」存在極高的技術門檻:
1. 不對稱性與翹曲(Warpage):方形結構在邊角容易產生應力集中,導致熱膨脹不均,造成基板變形 。
2. 設備重新設計:傳統半導體設備多為圓形對稱設計(如清洗、研磨),轉為方形基板需要全新的生產流程 。
3. 系統整合難度:從搬運方式到節拍控制都必須重新設計,300 多道程序必須重新簡化與整合 。
CoPoS 何時量產?台積電時程與布局
台積電正加速布局,防止英特爾與三星的超車 。
綜合多方消息,CoPoS試產線將設於台積電子公司采鈺龍潭廠,預計 2026 年 6 月起進機試產 。
首條量產線預計落腳興建中的嘉義廠,美國亞利桑那廠亦規畫同步或接續跟進 。
量產時間推估約在 2028 年底正式投入大規模量產 。
CoPoS量產時間表(2026試產、2028量產)
進機試產階段
地點:台積電子公司采鈺龍潭廠
重點:導入生產線與機台驗證。
正式大規模量產
首發產線:嘉義廠
同步布局:美國亞利桑那廠規劃跟進。
CoPoS概念股有哪些?受惠股與供應鏈名單一次整理
CoPoS 的興起,將帶動整體先進封裝與設備材料廠的商機,投資人最關注的是CoPoS 受惠股有哪幾檔?
台積電體系之中,除了日月光、矽品封測廠之外,目前流傳的首波CoPoS設備供應商,包括東京威力科創、Screen、科磊、應材、迪斯科等國際大廠外,還包括十餘家台廠。
例如溼製程的辛耘、弘塑;自動化的家登、盟立、萬潤;熱製程的志聖、印能;AOI光學檢測的大量、倍利科、晶彩科等上市櫃廠家,多數延續CoWoS供應鏈,陣容浩大地開始布局下一波先進封裝產能。
CoPoS目前流傳設備供應商
| 領域分類 | 合作夥伴 |
|---|---|
| 濕製程設備 | 辛耘(3583)、弘塑(3131) |
| 自動化設備 | 家登(3680)、盟立(2464)、萬潤(6187) |
| 熱製程/烘烤設備 | 志聖(2467)、印能(7734) |
| AOI 光學檢測 | 大量(3167)、倍利科(7822)、晶彩科(3535) |
CoPoS 常見問題 FAQ
Q1:CoPoS是什麼?
CoPoS(Chip-on-Panel-on-Substrate)是台積電研發的次世代面板級先進封裝技術,旨在透過方形基板提升 AI 晶片產能 。
Q2:CoPoS和CoWoS差在哪?
最核心差異在於「形狀」與「中介層材料」。CoWoS 使用圓形矽晶圓,利用率約 65%;CoPoS 使用方形面板,利用率提升至 95% 以上,且能產出更多晶片 。
Q3:CoPoS何時量產?
台積電預計 2026 年中開始試產,正式大規模量產目標設定在 2028 年底 。
Q4:CoPoS概念股有哪些?
主要包含濕製程設備廠(如辛耘、弘塑)、自動化設備廠(如萬潤、家登)以及封裝大廠日月光、力成等 。











_20260421104922.jpg_280x210.jpg)
